因為專業
所以領先


三維集成技術作為先進封裝的重要組成部分,主要通過垂直堆疊和高密度互連來提升芯片性能、縮小封裝尺寸、降低功耗,是應對摩爾定律放緩的關鍵技術之一。下面為你分析其發展現狀和核心市場應用。

三維集成技術主要包括 2.5D封裝(使用中介層進行水平互連)和 3D封裝(直接進行芯片垂直堆疊),其核心在于通過 TSV(硅通孔)、混合鍵合(Hybrid Bonding)、微凸點(Microbumps) 等工藝實現芯片間的高密度互連。
國內技術發展與產業布局
中國大陸的先進封裝技術發展迅猛,多家企業已布局2.5D/3D封裝技術并實現量產。下表匯總了國內主要廠商的技術布局和產能規劃:
| 企業名稱 | 技術布局與平臺 | 最新進展/產能規劃 | 技術特點/應用方向 |
| 長電科技 | XDFOI Chiplet高密度多維異構集成工藝 | 已實現4nm節點多芯片系統集成封裝量產,最大封裝體面積達1500mm2 | 支持2D, 2.5D, 3D集成,線寬/線距可達2μm,可集成多芯片和HBM |
| 通富微電 | VISionS平臺(強調垂直集成和高密度互連) | 與AMD合作開發3D堆疊技術已量產,計劃投入多維異構先進封裝技術研發與產業化 | Chiplet架構、2.5D平臺、HBM封裝 |
| 華天科技 | HMatrix平臺(含eSinC? 2.5D平臺) | 南京華天先進封裝有限公司成立,重點發展2.5D/3D等高端封裝測試業務 | RDL Interposer, Si Interposer, 3D Stack與Cu-Cu鍵合 |
| 盛合晶微 | 3D SmartPoser平臺(含3DFO晶圓級系統集成技術) | 2.5D集成市場市占率業內第一,3D封裝業內引領 | 超高垂直銅柱互連,高密度RDL和TIV特性 |
| 甬矽電子 | FH-BSAP 2.5D平臺、Vertical系列晶圓級垂直芯片堆棧封裝 | 推進總投資達111億元的二期廠房建設,2.5D平臺FH-BSAP正布局客戶 | 通過TSV/Micro bump/TCB/混合鍵合等實現垂直堆疊 |
| 物元半導體 | 混合鍵合(Hybrid Bonding)技術平臺 | 2023年初建成國內首條12英寸混合鍵合先進封裝實驗線,2025年8月光刻機入駐產線 | 專注于晶圓對晶圓(WoW)、芯片對晶圓(CoW)等異構、異質集成中道工藝 |
| 佰維存儲 | - | 廣東芯成漢奇一期產能2025年Q4投產(30萬片/年) | 掌握16層疊Die等先進封裝工藝,瞄準HBM、存算一體高端需求 |
| 深科技 | - | 完成了16層堆疊技術的研發,并具備了量產能力 | 超薄POPt封裝技術,專注存儲芯片封測,有望切入HBM封裝領域 |
市場規模與增長
全球市場:預計2.5D/3D封裝市場將從2023年的92億美元增長至2029年的257.7億美元,年復合增長率(CAGR)高達18.7%,是增長最快的細分領域之一。
中國市場:2024年中國先進封裝市場規模預計達698億元,2025年有望達到852億元,但先進封裝市場滲透率(約40%)仍低于全球平均水平(55%),中長期仍有顯著提升空間。
關鍵技術挑戰
熱管理難題:3D堆疊導致熱密度驟增(如AI芯片熱流密度超100W/cm2),需采用微流體冷卻等新型散熱方案。
可靠性問題:TSV電遷移失效、熱應力導致的界面分層風險(如300mm晶圓堆疊后翹曲量達50μm以上)。
工藝復雜度與成本:混合鍵合(Hybrid Bonding)對準精度要求高(<0.1μm),TSV深寬比向20:1演進,3D封裝成本可占芯片總成本30%-50%。
設備與材料依賴:混合鍵合設備、高端光刻膠等仍依賴進口,國產化率有待提升。
高性能計算(HPC)與人工智能(AI)
應用需求:AI訓練芯片(如GPU)需要高帶寬內存(HBM)支持,3D集成技術(如2.5D中介層、3D堆疊)是實現CPU/GPU與HBM高性能異構集成的關鍵。
典型案例:英偉達H100 GPU通過臺積電CoWoS-S(2.5D)封裝集成6顆HBM3,顯存帶寬達3TB/s8;長電科技為AMD Zen4架構CPU提供4nm Chiplet封裝支持。
消費電子與移動設備
應用需求:智能手機、AR/VR設備對輕薄化、高性能和低功耗的極致追求。
技術方案:采用扇出型晶圓級封裝(Fan-Out WLP)、PoP(Package on Package)等3D集成技術。
效益:采用3D封裝的移動芯片功耗可降低20%-30%,面積節省40%以上。
汽車電子與自動駕駛
應用需求:車載傳感器(激光雷達、攝像頭)、域控制器需要高可靠性、高集成度的封裝解決方案。
應用方向:3D封裝用于集成毫米波雷達芯片與信號處理單元,降低延遲;碳化硅(SiC)功率模塊通過3D結構優化散熱。
數據存儲與內存
應用需求:高帶寬內存(HBM)、存算一體等高端存儲需求推動3D堆疊技術在存儲領域的應用。
技術實現:通過TSV技術實現多層DRAM堆疊(如HBM)。深科技、佰維存儲等國內企業已掌握16層堆疊技術,并積極布局HBM封裝。
醫療電子與物聯網(IoT)
應用需求:植入式醫療設備(如心臟起搏器)、可穿戴設備需要微型化、高集成度的系統級封裝(SiP)。
技術應用:3D SiP集成傳感器、處理器和無線模塊,實現設備的小型化和功能集成。
技術迭代加速:互連技術向混合鍵合(Hybrid Bonding) 發展,銅-銅直接鍵合間距向1μm以下邁進,互連密度提升10倍8。TSV持續微縮化,從當前5μm直徑向1μm發展。
異構集成擴展:Chiplet(小芯片) 理念普及,UCIe等接口標準推動不同制程、不同材質芯片(如邏輯芯片、模擬芯片、硅光芯片、GaN/SiC功率器件)的“混搭”集成。
材料創新:低k介質、石墨烯-金屬復合材料等新型熱界面材料(TIM)應用于芯片層間熱擴散;玻璃基板(TGV)因其低成本(據稱為硅基1/8)和優異特性受到關注。
產業鏈與生態協同:設計與制造協同優化,EDA工具(如Synopsys 3DIC Compiler)支持3DIC全流程設計仿真。國內產業鏈上下游協同加強,關鍵設備和材料國產化進程加速。
三維集成技術通過“堆疊”和“互聯”創新,已成為提升芯片性能、延續摩爾定律的重要路徑。國內企業在2.5D/3D封裝技術上已取得顯著進展,并在AI/HPC、消費電子、汽車電子等領域實現應用,市場增長迅猛。未來,技術的進一步發展將依賴于混合鍵合、新材料、熱管理等關鍵領域的突破,以及Chiplet生態的完善和產業鏈的協同創新。
水基清洗的工藝和設備配置選擇對清洗精密器件尤其重要,一旦選定,就會作為一個長期的使用和運行方式。水基清洗劑必須滿足清洗、漂洗、干燥的全工藝流程。
污染物有多種,可歸納為離子型和非離子型兩大類。離子型污染物接觸到環境中的濕氣,通電后發生電化學遷移,形成樹枝狀結構體,造成低電阻通路,破壞了電路板功能。非離子型污染物可穿透PC B 的絕緣層,在PCB板表層下生長枝晶。除了離子型和非離子型污染物,還有粒狀污染物,例如焊料球、焊料槽內的浮點、灰塵、塵埃等,這些污染物會導致焊點質量降低、焊接時焊點拉尖、產生氣孔、短路等等多種不良現象。
這么多污染物,到底哪些才是最備受關注的呢?助焊劑或錫膏普遍應用于回流焊和波峰焊工藝中,它們主要由溶劑、潤濕劑、樹脂、緩蝕劑和活化劑等多種成分,焊后必然存在熱改性生成物,這些物質在所有污染物中的占據主導,從產品失效情況來而言,焊后殘余物是影響產品質量最主要的影響因素,離子型殘留物易引起電遷移使絕緣電阻下降,松香樹脂殘留物易吸附灰塵或雜質引發接觸電阻增大,嚴重者導致開路失效,因此焊后必須進行嚴格的清洗,才能保障電路板的質量。
合明科技研發的水基清洗劑配合合適的清洗工藝能為芯片封裝前提供潔凈的界面條件。
合明科技運用自身原創的產品技術,滿足芯片封裝工藝制程清洗的高難度技術要求,打破國外廠商在行業中的壟斷地位,為芯片封裝材料全面國產自主提供強有力的支持。
推薦使用合明科技水基清洗劑產品。
合明科技致力于為SMT電子表面貼裝清洗、功率電子器件清洗及先進封裝清洗提供高品質、高技術、高價值的產品和服務。合明科技 (13691709838)Unibright 是一家集研發、生產、銷售為一體的國家高新技術、專精特新企業,具有二十多年的水基清洗工藝解決方案服務經驗,掌握電子制程環保水基清洗核心技術。水基技術產品覆蓋從半導體芯片封測到 PCBA 組件終端的清洗應用。是IPC-CH-65B CN《清洗指導》標準的單位。合明科技全系列產品均為自主研發,具有深厚的技術開發能力,擁有五十多項知識產權、專利,是國內為數不多擁有完整的電子制程清洗產品鏈的公司。合明科技致力成為芯片、電子精密清洗劑的領先者。以國內自有品牌,以完善的服務體系,高效的經營管理機制、雄厚的技術研發實力和產品價格優勢,為國內企業、機構提供更好的技術服務和更優質的產品。合明科技的定位不僅是精湛技術產品的提供商,另外更具價值的是能為客戶提供可行的材料、工藝、設備綜合解決方案,為客戶解決各類高端精密電子、芯片封裝制程清洗中的難題,理順工藝,提高良率,成為客戶可靠的幫手。
合明科技憑借精湛的產品技術水平受邀成為國際電子工業連接協會技術組主席單位,編寫全球首部中文版《清洗指導》IPC標準(標準編號:IPC-CH-65B CN)(“Guidelines for Cleaning of Printed Boards and Assemblies”),IPC標準是全球電子行業優先選用標準,是集成電路材料產業技術創新聯盟會員成員。
主營產品包括:集成電路與先進封裝清洗材料、電子焊接助焊劑、電子環保清洗設備、電子輔料等。
半導體技術應用節點:FlipChip ;2D/2.5D/3D堆疊集成;COB綁定前清洗;晶圓級封裝;高密度SIP焊后清洗;功率電子清洗。
上一篇:半導體FCBGA與CSP封裝特點及應用分析和半導···
下一篇:沒有了!

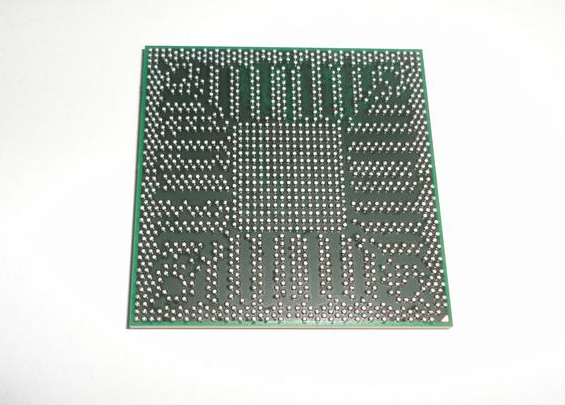



![[x]](/template/default/picture/closeimgfz1.svg)