因?yàn)閷I(yè)
所以領(lǐng)先


我們來(lái)對(duì)臺(tái)積電(TSMC)兩大核心先進(jìn)封裝技術(shù)——CoWoS和InFO進(jìn)行詳細(xì)的解析和對(duì)比。
這兩種技術(shù)是臺(tái)積電從一家純晶圓制造廠(Foundry)轉(zhuǎn)型為“晶圓制造與封裝服務(wù)提供商”的關(guān)鍵,開(kāi)啟了“后摩爾定律”時(shí)代,通過(guò)封裝技術(shù)來(lái)持續(xù)提升芯片性能。

傳統(tǒng)封裝(Package)是將制造好的芯片(Die)放入封裝基板,用引線鍵合(Wire Bonding)的方式連接引腳,主要起保護(hù)、連接和散熱的作用。
先進(jìn)封裝(Advanced Packaging) 則更側(cè)重于:
提升互聯(lián)密度:用更短、更密集的互連(如硅通孔TSV、再布線層RDL)替代長(zhǎng)引線,顯著減少延遲和功耗。
異質(zhì)集成(Heterogeneous Integration):將不同工藝節(jié)點(diǎn)、不同功能、甚至不同材質(zhì)的芯片(如CPU、GPU、HBM、射頻芯片等)集成在一個(gè)封裝內(nèi),實(shí)現(xiàn)類似單芯片的性能。
縮小整體尺寸:尤其對(duì)于移動(dòng)設(shè)備,在提升性能的同時(shí)保持小巧外形。
CoWoS是臺(tái)積電2.5D先進(jìn)封裝技術(shù)的旗艦和開(kāi)創(chuàng)者,最初為NVIDIA的GPU和AMD的處理器與高帶寬內(nèi)存(HBM)集成而開(kāi)發(fā)。
CoWoS的核心是在芯片和封裝基板之間插入一個(gè)“硅中介層(Silicon Interposer)”。這個(gè)中介層是CoWoS技術(shù)的精髓。
結(jié)構(gòu)分解:
Chip (Die): 計(jì)算芯片,如CPU、GPU、ASIC等。
Wafer (Interposer): 硅中介層。這是一片經(jīng)過(guò)特殊加工的硅片,上面制作有高密度的互連線(Micro Wiring)和硅通孔(TSV - Through-Silicon Via)。
Substrate: 傳統(tǒng)的有機(jī)封裝基板,連接中介層和PCB主板。
關(guān)鍵工藝步驟:
制造硅中介層:在硅晶圓上利用前道半導(dǎo)體工藝(光刻、刻蝕、沉積)制作出極其精細(xì)的金屬互連層(線寬/線距可達(dá)亞微米級(jí)別)。
加工TSV:在中介層上刻蝕出通孔并填充導(dǎo)電材料(如銅),這是連接上下層的垂直通道。
Chip on Wafer (CoW):將多個(gè)預(yù)先制造好的芯片(如GPU Die和HBM Die)通過(guò)微凸塊(Microbump) 以超高精度倒裝焊(Flip-Chip)的方式鍵合到硅中介層上。這一步是在晶圓(Wafer)級(jí)別完成的。
封裝與測(cè)試:將鍵合好芯片的整個(gè)中介層切割成單個(gè)單元,然后通過(guò)更大的焊料凸塊(C4 Bump) 倒裝焊到有機(jī)封裝基板上。
最終封裝:加蓋、注塑成型、安裝散熱器等,完成最終封裝。
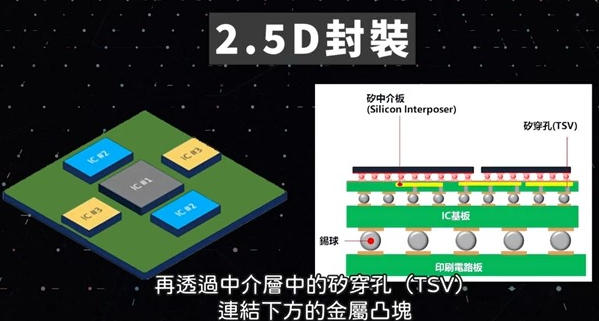
極高的互聯(lián)密度和帶寬:硅中介層上的線路可以做得像芯片內(nèi)部一樣精細(xì),遠(yuǎn)超任何有機(jī)基板的能力。這使得多個(gè)芯片(如邏輯芯片和HBM)之間可以實(shí)現(xiàn)數(shù)千條超短距離、低功耗的互連,提供極高的帶寬(這也是HBM得以實(shí)現(xiàn)的基礎(chǔ))。
優(yōu)異的熱性能和信號(hào)完整性:硅的熱膨脹系數(shù)(CTE)與芯片本身非常接近,減少了熱應(yīng)力。硅中介層的屏蔽作用也改善了信號(hào)完整性。
強(qiáng)大的異質(zhì)集成能力:可以集成來(lái)自不同晶圓廠、不同工藝節(jié)點(diǎn)的芯片。
高性能計(jì)算(HPC):NVIDIA的A100、H100系列GPU;AMD的MI系列加速卡;NVIDIA的Blackwell架構(gòu)B200 GPU。
人工智能(AI)/機(jī)器學(xué)習(xí)(ML)加速器:Google的TPU、Xilinx(AMD)的FPGA等。
高端網(wǎng)絡(luò)芯片:需要極高吞吐量的交換機(jī)和路由器芯片。
CoWoS本身也在迭代:
CoWoS-S:最經(jīng)典的版本,使用Silicon Interposer(硅中介層)。
CoWoS-R:使用RDL(再布線層)代替硅中介層,成本更低,適用于互聯(lián)密度要求稍低的場(chǎng)景。
CoWoS-L:Local Silicon Interposer(局部硅中介層)與RDL混合使用,在需要高密度互聯(lián)的區(qū)域(如芯片之間)使用小塊硅中介層,其他區(qū)域用RDL,平衡了性能和成本。
InFO是臺(tái)積電的另一項(xiàng)開(kāi)創(chuàng)性技術(shù),屬于扇出型(Fan-Out)封裝。它最初是為了滿足蘋果iPhone處理器對(duì)更薄、性能更好、集成度更高的封裝需求而開(kāi)發(fā)的。
InFO技術(shù)的核心是去掉了中介層和封裝基板,直接利用環(huán)氧塑封料(EMC) 重構(gòu)一個(gè)“假”的晶圓,并在上面制作高密度的再布線層(RDL - Redistribution Layer) 來(lái)連接多個(gè)芯片和對(duì)外引腳。
結(jié)構(gòu)分解:
芯片(Die):被集成的芯片。
塑封料(EMC):包裹芯片,形成重構(gòu)晶圓。
再布線層(RDL):在塑封體表面制作的銅金屬布線層,將芯片的觸點(diǎn)“扇出”到更廣的面積上,并實(shí)現(xiàn)芯片間的互連。
焊球(Solder Ball):直接連接到RDL上,用于連接PCB主板。
關(guān)鍵工藝步驟:
載板貼裝:將芯片(正面朝下)臨時(shí)粘貼在一個(gè)載板(Carrier)上。
模塑(Molding):用環(huán)氧塑封料(EMC)灌注并加熱固化,將芯片包裹起來(lái),形成一個(gè)“重構(gòu)晶圓(Reconstituted Wafer)”。
移除載板:將重構(gòu)晶圓從臨時(shí)載板上取下,露出芯片背面和埋入的芯片正面觸點(diǎn)。
制作RDL:在塑封后的晶圓表面進(jìn)行薄膜沉積、光刻、電鍍等工序,制作出多層精細(xì)的銅布線(RDL),這些布線將各個(gè)芯片的觸點(diǎn)連接起來(lái),并引到更大的節(jié)距上。
植球:在RDL上制作焊球。
切割:將重構(gòu)晶圓切割成單個(gè)封裝體。
更薄、更輕、尺寸更小:由于省去了中介層和封裝基板,InFO封裝的高度和尺寸顯著減小,非常適合移動(dòng)設(shè)備。
性能更優(yōu):互連路徑更短,減少了電感和電阻,提升了電源完整性和信號(hào)性能,降低了功耗。
成本潛力:省去了昂貴的硅中介層和部分基板,在量大時(shí)具有成本優(yōu)勢(shì)。
設(shè)計(jì)靈活性高:RDL層可以按需設(shè)計(jì),支持不同數(shù)量、不同尺寸的芯片集成。
移動(dòng)應(yīng)用處理器(AP):蘋果的A系列和M系列芯片(如A11到最新的A17 Pro,M1等)是InFO技術(shù)的最大用戶。
射頻芯片、電源管理芯片(PMIC)、網(wǎng)絡(luò)芯片等。
物聯(lián)網(wǎng)(IoT)和可穿戴設(shè)備:對(duì)尺寸和功耗有極致要求的領(lǐng)域。
InFO-PoP:最具代表性的變體。Package on Package。在處理器芯片的InFO封裝頂部再堆疊一顆DRAM內(nèi)存芯片(如LPDDR)。這大大節(jié)省了手機(jī)主板空間,已成為高端手機(jī)的標(biāo)準(zhǔn)方案。
InFO_oS:On Substrate,用于HPC領(lǐng)域,將多個(gè)芯片集成在更大的InFO封裝中,然后放在基板上,對(duì)標(biāo)CoWoS,但成本更低。
| 特性 | CoWoS (2.5D) | InFO (Fan-Out) |
| 核心結(jié)構(gòu) | 硅中介層(Silicon Interposer) + TSV | 再布線層(RDL) + 環(huán)氧塑封料(EMC) |
| 互聯(lián)密度 | 極高(中介層線寬/線距<1μm) | 高(RDL線寬/線距~2-10μm),但低于CoWoS |
| 性能 | 極致性能,專為超高帶寬(如HBM)設(shè)計(jì) | 優(yōu)秀,互連短,電性能好,但帶寬上限不及CoWoS |
| 厚度/尺寸 | 較厚(有中介層和基板) | 極薄(無(wú)中介層和基板),尺寸小 |
| 成本 | 非常高(使用了硅晶圓工藝) | 相對(duì)較低(省去硅中介層,使用晶圓級(jí)封裝) |
| 主要應(yīng)用 | HPC, AI, 高端GPU/CPU (NVIDIA, AMD) | 移動(dòng)AP, 射頻, IoT (Apple, Qualcomm, Mediatek) |
| 典型產(chǎn)品 | NVIDIA H100 GPU, AMD MI300 | Apple A17 Pro, 麒麟9000S |
CoWoS和InFO是臺(tái)積電針對(duì)不同市場(chǎng)賽道打造的兩把利劍:
CoWoS 是 “性能王者”,不惜成本追求極致的互聯(lián)帶寬和計(jì)算性能,服務(wù)于數(shù)據(jù)中心、AI等高端市場(chǎng)。
InFO 是 “集成與效率大師”,在有限的空間內(nèi)實(shí)現(xiàn)高度集成和優(yōu)良性能,主打移動(dòng)消費(fèi)電子市場(chǎng),平衡了性能、尺寸和成本。
兩者并非替代關(guān)系,而是互補(bǔ)共存。它們共同構(gòu)成了臺(tái)積電在先進(jìn)封裝領(lǐng)域的強(qiáng)大護(hù)城河,使其能夠?yàn)榭蛻籼峁那把匦酒圃斓礁叨朔庋b的“一條龍”服務(wù),這也是臺(tái)積電維持其技術(shù)領(lǐng)導(dǎo)地位的關(guān)鍵戰(zhàn)略之一。隨著技術(shù)的發(fā)展,兩者也在相互借鑒和融合(如CoWoS-L和InFO_oS),以滿足日益復(fù)雜的異質(zhì)集成需求。

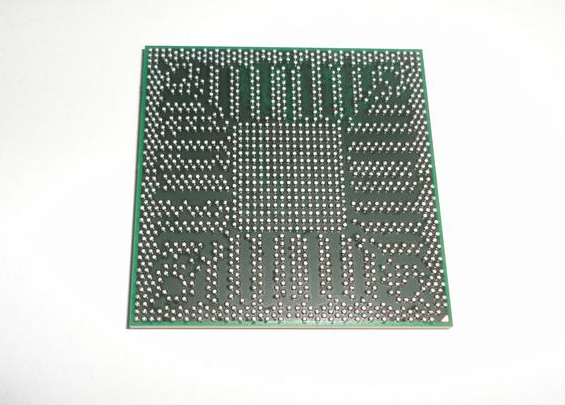



![[x]](/template/default/picture/closeimgfz1.svg)