因為專業
所以領先


板級封裝(Panel Level Packaging, PLP)是一種基于大尺寸基板(如510mm×515mm或600mm×600mm面板)的先進封裝技術,通過高密度布線、芯片重構和模塑工藝實現系統集成。其核心工藝流程和特點如下:
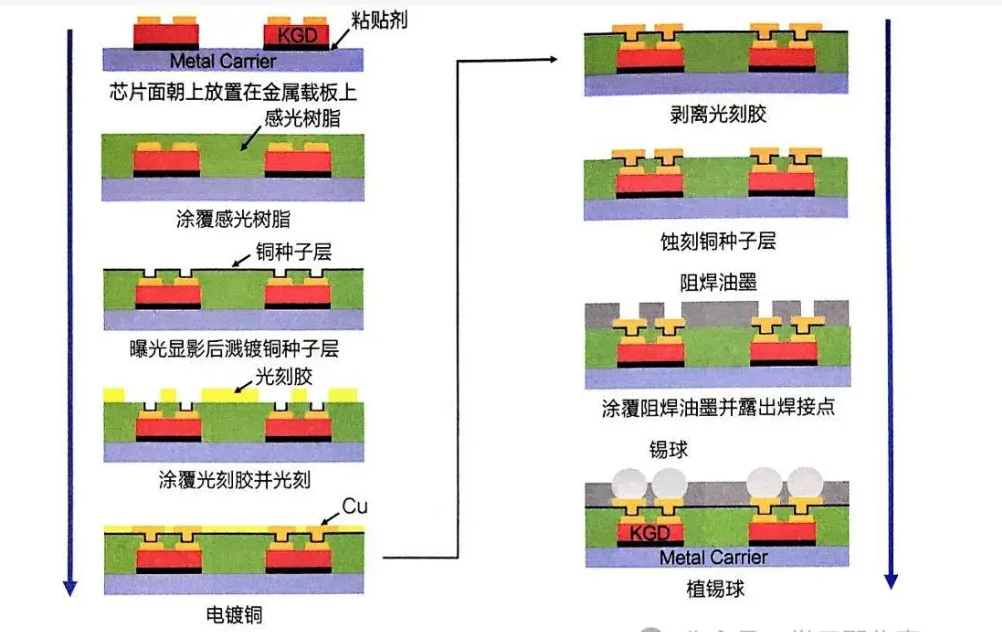
基板準備:在電路板表面預置凹陷的焊盤(第一焊墊),作為后續互連的基礎。
芯片貼裝:將切割后的裸片(Die)或元件通過鍵合層固定于基板,確保焊盤對齊。貼裝方式包括面朝上(Face Up)或面朝下(Face Down)。
鍵合工藝:使用可光刻鍵合材料、芯片粘結膜(DAF)或聚合物材料進行固定,避開焊盤區域以形成空隙。
電鍍銅柱/凸塊:通過光刻、濺射金屬膜(如銅、鈦)和電鍍工藝,在焊盤空隙中形成導電凸塊,實現芯片與基板的垂直互連。
再分布層(RDL):采用涂布、曝光、顯影、電鍍和刻蝕工藝制作高密度布線層,擴展I/O端口并優化信號路徑。
環氧樹脂塑封:使用環氧模塑料(EMC)對芯片和基板進行整體包封,保護內部結構并增強機械強度。
研磨與開孔:研磨去除多余材料,露出銅柱或凸塊,后續通過光刻去除鈍化層,形成外部引腳或錫球焊接區域。
植球與外引腳處理:在RDL層接觸點種植錫球或形成凸塊下金屬層(UBM),完成外部電氣連接。
切割與檢測:將大面板切割為獨立封裝體,并進行電性能測試和可靠性驗證。
三維集成:支持芯片埋入基板內部(如埋入式封裝)或堆疊,縮短互連路徑,減少寄生效應,提升高頻信號質量。
高密度布線:RDL層線寬可達10μm以下,支持多芯片異構集成,適用于復雜模組(如射頻前端、電源管理模塊)。
散熱優化:通過環氧樹脂和金屬涂層(如銅/不銹鋼)實現高效熱管理,降低芯片工作溫度。
電磁屏蔽:采用濺射或電鍍工藝形成金屬屏蔽層,減少信號干擾,適用于射頻和傳感器芯片。
材料利用率高:矩形面板相比圓形晶圓減少邊緣浪費(晶圓級封裝利用率約64%,板級可達93%)。
規模效應顯著:單次封裝可處理數千顆芯片,成本比晶圓級封裝降低約66%。
中低端市場:如功率IC、射頻模塊、PMIC等,逐步向高端領域(如HBM、AI芯片)擴展。
車規級芯片:新能源汽車中77%的半導體價值可通過扇出型板級封裝實現,滿足高可靠性和成本需求。
技術升級:向10μm以下線寬、3D堆疊和混合埋入(芯片+無源元件)方向發展。
產業鏈協同:面板廠通過改造設備切入板級封裝市場,加速產業化進程。
國產化加速:國內企業(如奕成科技、華潤微)已實現量產,推動設備(如曝光機、研磨機)國產替代。
如需進一步了解具體工藝參數或應用案例,可參考等來源。





![[x]](/template/default/picture/closeimgfz1.svg)