因為專業
所以領先


定義與原理
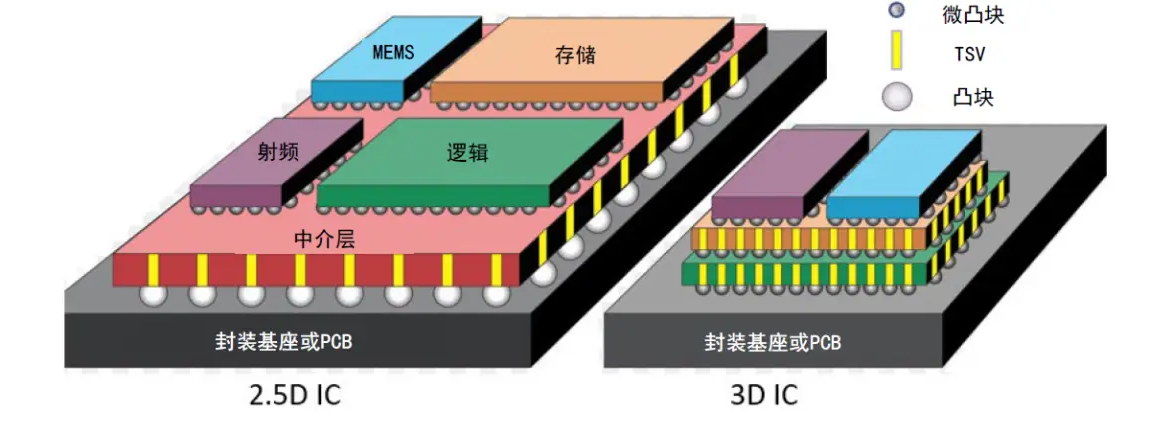
晶圓級封裝(Wafer Level Packaging, WLP)工藝詳細解說
晶圓級封裝(WLP)是一種直接在晶圓上完成封裝的技術,與傳統封裝(切割后再封裝)相比,具有體積小、成本低、性能優的特點,廣泛應用于先進半導體器件(如CIS、MEMS、射頻芯片等)。

?一、核心工藝流程?
?晶圓準備?
原始晶圓完成前道制程(如光刻、蝕刻、沉積等),表面形成功能芯片陣列。
清潔晶圓表面,確保無顆粒污染。
?再分布層(Redistribution Layer, RDL)?
?目的?:將芯片I/O焊盤重新布局到更易封裝的位置。
?步驟?:
① 沉積介電層(如PI或SiO?);
② 光刻開孔;
③ 濺射/電鍍金屬(Cu或Al)形成導線;
④ 重復多層RDL以實現高密度互連。
?凸點(Bump)制作?
?技術類型?:
?焊球凸點?:通過電鍍或植球法形成SnAg/Cu焊球。
?銅柱凸塊(Cu Pillar)?:用于高密度、高性能芯片(如先進處理器)。
?關鍵工藝?:光刻膠圖形化、金屬電鍍、去膠、回流焊。
?晶圓級封裝成型?
?塑封(Molding)?:在晶圓表面覆蓋環氧樹脂,保護芯片并增強機械強度。
?扇出型(Fan-Out WLP)?:將芯片重新布局到更大載體,擴展I/O數量(如蘋果A系列處理器)。
?晶圓切割與測試?
切割封裝后的晶圓為單顆芯片。
電性測試(Probe Test)篩選良品。
?二、關鍵技術分類?
?扇入型(Fan-In WLP)?
I/O引腳在芯片區域內,適用于低引腳數器件(如CIS)。
?扇出型(Fan-Out WLP)?
I/O擴展到芯片外部,支持高密度互連(如移動SoC)。
?3D WLP(TSV集成)?
通過硅通孔(TSV)實現垂直堆疊,提升集成度(如HBM內存)。
?三、核心優勢?
?小型化?:封裝尺寸≈芯片尺寸,適合便攜式設備。
?高密度互連?:RDL技術實現微米級布線精度。
?電性能優化?:短互連路徑降低電阻/電感,提升高頻性能。
?成本效率?:批量處理晶圓,降低單顆芯片封裝成本。
?四、典型應用場景?
?圖像傳感器(CIS)?:如手機攝像頭芯片(索尼/三星)。
?射頻前端模組?:5G/Wi-Fi 6E芯片(Qorvo/Broadcom)。
?MEMS器件?:陀螺儀、壓力傳感器(博世/意法半導體)。
?先進邏輯芯片?:移動處理器、AI加速器(臺積電InFO技術)。
?五、技術挑戰?
?工藝復雜度高?:多層RDL和微凸點需納米級精度。
?熱管理?:高密度封裝易導致局部過熱。
?材料匹配?:介電層與金屬的熱膨脹系數需兼容。
?成本門檻?:設備投資大(如電鍍機、光刻機)。
?六、未來趨勢(2025年視角)?
?異構集成?:結合Chiplet和WLP實現多功能芯片堆疊。
?超薄封裝?:<100μm厚度滿足可穿戴設備需求。
?新材料?:低溫焊接材料、高導熱塑封膠的應用。
總結
晶圓級封裝通過“晶圓級批量處理”和“高密度互連”技術,成為5G、AI、IoT時代的關鍵封裝方案,未來將向三維集成、超薄化方向持續演進。
先進封裝清洗劑W3100介紹:
半導體封裝清洗劑W3100是合明科技開發具有創新型的中性水基清洗劑,專門設計用于浸沒式的清洗工藝。適用于清洗去除半導體電子器件上的助焊劑殘留物,如引線框架、分立器件、功率模塊、倒裝芯片、攝像頭模組等。本品是PH中性的水基清洗劑,因此具有良好的材料兼容性。
半導體封裝清洗劑W3100的產品特點:
1、本品可以用去離子水稀釋后使用,稀釋后為均勻單相液,應用過程簡單方便。
2、產品PH值呈中性,對鋁、銅、鎳、塑料、標簽等敏感材料上顯示出極好的材料兼容性。
3、不含鹵素,材料環保;氣味清淡,使用液無閃點,使用安全,不需要額外的防爆措施。
4、由于PH中性,減輕污水處理難度。
半導體封裝清洗劑W3100的適用工藝:
水基清洗劑W3100適用于浸沒式的清洗工藝。
半導體封裝清洗劑W3100產品應用:
水基清洗劑W3100是合明科技開發具有創新型的中性水基清洗劑,適用于清洗去除半導體電子器件上的助焊劑殘留物,如引線框架清洗、分立器件清洗、功率模塊清洗、倒裝芯片清洗、攝像頭模組清洗等。本產品PH值呈中性,對鋁、銅、鎳、塑料、標簽等敏感材料上顯示出極好的材料兼容性。





![[x]](/template/default/picture/closeimgfz1.svg)