因為專業
所以領先


Wire Bonding技術概述與核心原理
Wire Bonding(引線鍵合)是半導體封裝中關鍵的芯片連接技術,通過金屬引線將芯片表面電極與封裝載體引腳連接,實現電信號傳輸。其核心原理是對金屬絲和壓焊點施加熱、超聲能量與壓力,使接觸面金屬發生塑性變形并破壞氧化膜,通過金屬原子相互擴散形成金屬化合物,完成固態連接1。該技術廣泛應用于集成電路、功率器件等封裝場景,直接影響電子設備的性能與可靠性。

Wire Bonding過程需經過9個關鍵階段,涉及精準的機械運動與能量控制:
打火準備:焊頭移動至打火高度,準備形成金球(針對球焊工藝)
第一焊點定位:焊頭下降至第一焊點搜索高度,識別芯片焊盤位置
接觸與焊接:通過超聲振動與壓力實現第一焊點(芯片端)連接
線弧形成:焊頭上升至線弧高度,在芯片與引線框架間形成特定弧度引線
第二焊點焊接:移動至引線框架引腳位置,完成第二焊點連接
尾絲處理:焊頭上升至尾絲高度并拉斷引線,準備下一次循環
焊接質量取決于四大核心參數的協同控制:
Time(時間):超聲作用時長,影響金屬擴散程度
Power(功率):超聲能量強度,過大會導致焊盤損傷
Force(壓力):焊頭施加壓力,不足易導致虛焊
Temperature(溫度):工作臺加熱溫度,通常為150-250℃
劈刀作為關鍵工具,其幾何參數直接影響焊接質量:
CD徑(Chamfer Diameter):過大導致焊接強度下降,推薦值0.8-1.2mil
Chamfer角:角度越大形成的金球尺寸越大,通常控制在30°-60°
OR(Outer Radius):影響引線弧度穩定性,過小易產生Hill Crack缺陷
| 線材類型 | 核心優勢 | 主要局限 | 應用場景 |
| 金線 | 抗氧化性優異、高溫可靠性好、應力小 | 成本高(約為銅線的8-10倍)、易產生Kirkendall空洞 | 高端IC、航空航天器件 |
| 銅線 | 成本低(僅為金線1/5)、電阻率低(1.7μΩ·cm) | 硬度大易損傷焊盤、需氮氣保護 | 消費電子、汽車電子 |
| 鈀銅線 | 耐腐蝕性優于純銅、存儲周期長(開封后7天)1 | 焊接需純氮氣環境 | 潮濕環境應用 |
| 銀合金線 | 導電率高、價格介于金銅之間 | 易遷移、可靠性數據不足 | 中低端功率器件 |
傳統封裝場景:DIP、SOP等封裝形式的內引線連接,占全球封裝市場60%以上份額
功率器件封裝:IGBT模塊中采用粗鋁線實現大電流傳輸
MEMS器件:傳感器芯片與ASIC的低應力連接
材料替代:銅線在消費電子領域滲透率已超50%,鈀銅線逐步解決可靠性問題
工藝優化:采用機器視覺技術實現焊點自動檢測,良率提升至99.95%
與Flip Chip競爭:在中小引腳數場景(<200 I/O)仍保持成本優勢,但面臨Flip Chip高密度封裝替代壓力
Wirepull Test:測試引線抗拉強度,金線通常要求>5g
Ball Shear Test:評估第一焊點附著力,標準值>20gf
IMC覆蓋率:金屬間化合物覆蓋面積需≥80%,確保連接可靠性
彈坑實驗(Crater Test):檢查焊盤鋁層是否出現損傷
虛焊:因壓力不足或氧化導致的連接強度不足
焊盤剝離:超聲功率過大導致芯片鋁層損傷
引線斷裂:線弧弧度異常引發的機械應力集中
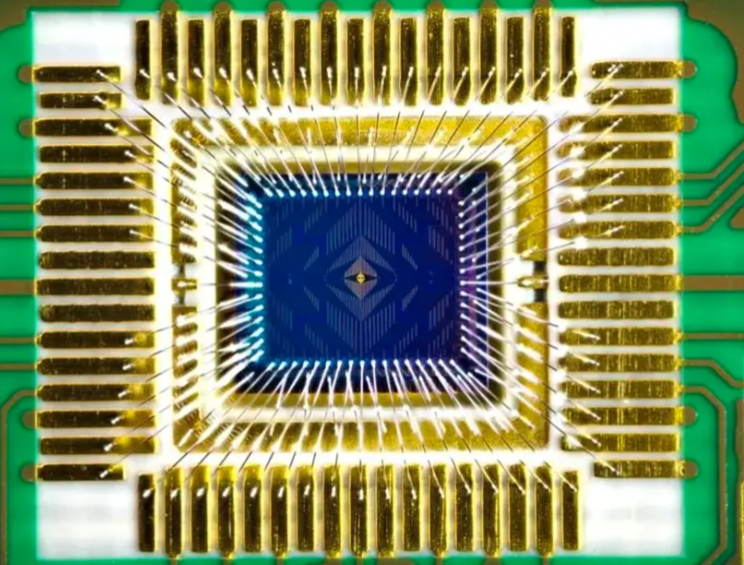
作為擁有60余年歷史的成熟技術,Wire Bonding憑借工藝兼容性強、成本可控等優勢,仍是中低引腳數封裝的主流方案。盡管面臨Flip Chip等新技術的挑戰,但其在汽車電子、功率器件等領域的應用仍不可替代。未來通過銅線工藝優化、智能化裝備升級,該技術將持續在半導體封裝領域發揮重要作用。
IGBT模塊芯片清洗劑選擇:
水基清洗的工藝和設備配置選擇對清洗精密器件尤其重要,一旦選定,就會作為一個長期的使用和運行方式。水基清洗劑必須滿足清洗、漂洗、干燥的全工藝流程。
污染物有多種,可歸納為離子型和非離子型兩大類。離子型污染物接觸到環境中的濕氣,通電后發生電化學遷移,形成樹枝狀結構體,造成低電阻通路,破壞了電路板功能。非離子型污染物可穿透PC B 的絕緣層,在PCB板表層下生長枝晶。除了離子型和非離子型污染物,還有粒狀污染物,例如焊料球、焊料槽內的浮點、灰塵、塵埃等,這些污染物會導致焊點質量降低、焊接時焊點拉尖、產生氣孔、短路等等多種不良現象。
這么多污染物,到底哪些才是最備受關注的呢?助焊劑或錫膏普遍應用于回流焊和波峰焊工藝中,它們主要由溶劑、潤濕劑、樹脂、緩蝕劑和活化劑等多種成分,焊后必然存在熱改性生成物,這些物質在所有污染物中的占據主導,從產品失效情況來而言,焊后殘余物是影響產品質量最主要的影響因素,離子型殘留物易引起電遷移使絕緣電阻下降,松香樹脂殘留物易吸附灰塵或雜質引發接觸電阻增大,嚴重者導致開路失效,因此焊后必須進行嚴格的清洗,才能保障電路板的質量。
合明科技研發的水基清洗劑配合合適的清洗工藝能為芯片封裝前提供潔凈的界面條件。
合明科技運用自身原創的產品技術,滿足芯片封裝工藝制程清洗的高難度技術要求,打破國外廠商在行業中的壟斷地位,為芯片封裝材料全面國產自主提供強有力的支持。
推薦使用合明科技水基清洗劑產品。





![[x]](/template/default/picture/closeimgfz1.svg)